来源:广东佳讯电子有限责任公司 时间:2025-02-04 20:41:59 [举报]
SiC 肖特基势垒二极管在 1985 年问世,是 Yoshida 制作在 3C-SiC 上的,它的肖特基势垒高度用电容测量是 1.15 (±0.15) eV,用光响应测量是 1.11 (±0.03) eV,它的击穿电压只有8 V,只6H-SiC肖特基二极管的击穿电压大约有200 V,它是由 Glover. G. H 报道出来的。Bhatnagar 报道了个高压 400 V 6H-SiC 肖特基势垒二极管 ,这个二极管有低通态压降(1 V),没有反向恢复电流。随着碳化硅单晶、外延质量及碳化硅工艺水平不断地不断提高,越来越多性能的碳化硅肖特基二极管被报道。1993 年报道了只击穿电压超过 1000V的碳化硅肖特基二极管,该器件的肖特基接触金属是 Pd,它采用 N 型外延的掺杂浓度1×10cm,厚度是 10μm。的4H-SiC单晶的在 1995 年左右出现,它比6H-SiC的电子迁移率要高,临界击穿电场要大很多,这使得人们更倾向于研究4H-SiC的肖特基二极管。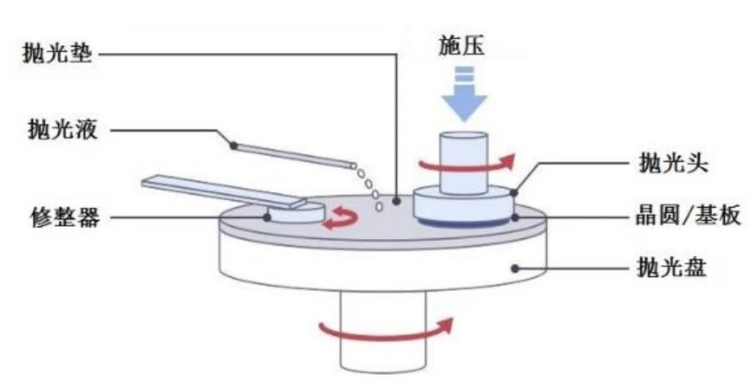
国内的SiC功率器件研究方面因为受到 SiC 单晶材料和外延设备的限制起步比较晚,但是却紧紧跟踪国外碳化硅器件的发展形势。国家十分重视碳化硅材料及其器件的研究, 在国家的大力支持下经已经初步形成了研究 SiC 晶体生长、SiC器件设计和制造的队伍。电子科技大学致力于器件结构设计方面,在新结构、器件结终端和器件击穿机理方面做了很多的工作,并且提出宽禁带半导体器件优值理论和宽禁带半导体功率双极型晶体管特性理论。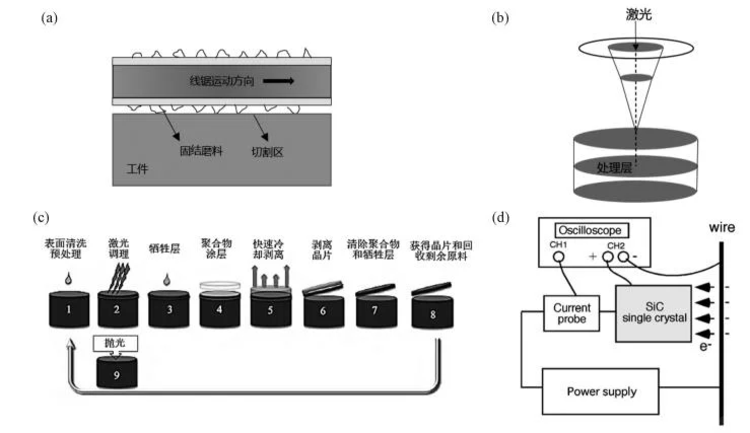
金属与半导体接触时,载流子流经肖特基势垒形成的电流主要有四种输运途径。这四种输运方式为:
1、N 型 4H-SiC 半导体导带中的载流子电子越过势垒顶部热发射到金属;
2、N 型 4H-SiC 半导体导带中的载流子电子以量子力学隧穿效应进入金属;
3、空间电荷区中空穴和电子的复合;
4、4H-SiC 半导体与金属由于空穴注入效应导致的的中性区复合。
标签:碳化硅肖特基二极管